
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Епитаксијални слоеви: Основа на напредни полупроводнички уреди
Слика 1: Ја илустрира корелацијата помеѓу концентрациите на допинг, дебелината на слојот и дефектниот напон за униполарни уреди.

Подготовката на SiC епитаксијални слоеви првенствено опфаќа техники како што се раст на испарување, епитаксија во течна фаза (LPE), молекуларна епитаксија со зрак (MBE) и хемиско таложење на пареа (CVD), при што CVD е доминантен метод за масовно производство во фабриките.
Табела 1: Дава компаративен преглед на методите за подготовка на главниот епитаксијален слој.

Револуционерен пристап вклучува раст на подлоги надвор од оската {0001} под специфичен агол на навалување, како што е прикажано на Слика 2(б). Овој метод значително ја зголемува густината на чекорите, додека ја намалува големината на чекорот, олеснувајќи ја нуклеацијата првенствено на местата за собирање чекори и на тој начин, дозволувајќи му на епитаксијалниот слој совршено да ја реплицира низата на натрупување на подлогата, елиминирајќи го коегзистирањето на политиповите.
Слика 2: Го демонстрира физичкиот процес на чекор-контролирана епитаксија во 4H-SiC.
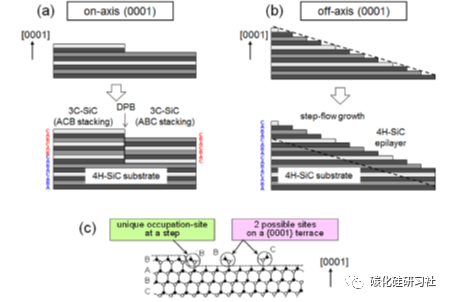
Слика 3: Ги прикажува критичните услови за раст на CVD во чекор-контролирана епитаксија за 4H-SiC.

Слика 4: Ги споредува стапките на раст под различни извори на силициум за 4H-SiC епитаксијата.

Во сферата на апликациите со низок и среден напон (на пример, уреди од 1200V), технологијата за епитаксии на SiC достигна зрела фаза, нудејќи релативно супериорна униформност во дебелината, концентрацијата на допинг и дистрибуцијата на дефекти, адекватно исполнувајќи ги барањата за SBD со низок и среден напон. , MOS, JBS уреди и други.
Сепак, високонапонскиот домен сè уште претставува значителни предизвици. На пример, уредите оценети на 10000 V бараат епитаксијални слоеви дебели приближно 100 μm, но овие слоеви покажуваат значително послаба дебелина и униформност на допингот во споредба со нивните нисконапонски колеги, а да не го спомнуваме штетното влијание на триаголните дефекти врз севкупните перформанси на уредот. Апликациите со висок напон, кои имаат тенденција да ги фаворизираат биполарните уреди, исто така поставуваат строги барања за животниот век на малцинските носачи, што бара оптимизација на процесот за да се подобри овој параметар.
Во моментов, на пазарот доминираат епитаксијални наполитанки SiC од 4 и 6 инчи, со постепено зголемување на процентот на епитаксијални наполитанки SiC со голем дијаметар. Големината на SiC епитаксијалните наполитанки е фундаментално одредена од димензиите на подлогите на SiC. Со 6-инчни SiC подлоги кои сега се комерцијално достапни, транзицијата од 4-инчна на 6-инчна SiC епитаксија е постојано во тек.
Како што напредува технологијата за производство на подлоги на SiC и се зголемуваат производствените капацитети, цената на подлогите на SiC постепено се намалува. Со оглед на тоа што супстратите сочинуваат повеќе од 50% од цената на епитаксијалните наполитанки, се очекува намалувањето на цените на подлогата да доведе до пониски трошоци за епитаксијата на SiC, а со тоа ветувајќи посветла иднина за индустријата.**




