
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Постигнување на висококвалитетен раст на SiC кристали преку контрола на температурен градиент во почетната фаза на раст
Вовед
Силициум карбид (SiC) е полупроводнички материјал со широк опсег што привлече значително внимание во последниве години поради неговите исклучителни перформанси во апликации со висок напон и висока температура. Брзиот напредок на методите за транспорт на физичка пареа (PVT) не само што го подобри квалитетот на единечните кристали SiC, туку и успешно го постигна производството на единечни кристали SiC од 150 mm. Сепак, квалитетот наSiC наполитанкисè уште бара дополнително подобрување, особено во смисла на намалување на густината на дефектот. Добро е познато дека постојат различни дефекти во одгледуваните SiC кристали, првенствено поради недоволното разбирање на механизмите за формирање на дефекти за време на процесот на раст на кристалите на SiC. Потребно е дополнително длабинско истражување на процесот на раст на PVT за да се зголеми дијаметарот и должината на SiC кристалите, а истовремено да се подобри стапката на кристализација, а со тоа да се забрза комерцијализацијата на уредите базирани на SiC. За да постигнеме висококвалитетен раст на SiC кристалите, се фокусиравме на контролата на температурниот градиент за време на почетната фаза на раст. Бидејќи гасовите богати со силикон (Si, Si2C) може да ја оштетат површината на кристалот на семето за време на почетната фаза на раст, воспоставивме различни температурни градиенти во почетната фаза и се прилагодивме на температурни услови со константен сооднос C/Si за време на главниот процес на раст. Оваа студија систематски ги истражува различните карактеристики на кристалите на SiC кои се одгледуваат користејќи изменети услови на процесот.
Експериментални методи
Растот на 6-инчните 4H-SiC булови беше изведен со користење на методот PVT на подлоги со C-лице надвор од оската 4°. Беа предложени подобрени услови на процесот за почетната фаза на раст. Температурата на раст беше поставена помеѓу 2300-2400°C, а притисокот се одржуваше на 5-20 Torr, во средина со азот и гас аргон. 6-инченНаполитанки 4H-SiCбеа фабрикувани преку стандардни техники за обработка на полупроводници. НаSiC наполитанкибеа обработени според различни услови на температурен градиент во почетната фаза на раст и гравирани на 600°C 14 минути за да се проценат дефектите. Густината на јамата (EPD) на површината беше измерена со помош на оптички микроскоп (OM). Целосната ширина на половина максимум (FWHM) вредности и мапирање слики на6-инчни SiC наполитанкибеа измерени со помош на систем за дифракција на Х-зраци (XRD) со висока резолуција.
Резултати и дискусија

Слика 1: Шема на механизмот за раст на кристалите SiC
За да се постигне висококвалитетен раст на еднокристалот на SiC, обично е неопходно да се користат извори на прашок со висока чистота на SiC, прецизно да се контролира односот C/Si и да се одржува постојана температура и притисок на раст. Дополнително, минимизирањето на загубата на семениот кристал и сузбивањето на формирањето на површинските дефекти на семениот кристал за време на почетната фаза на раст се клучни. Слика 1 ја илустрира шемата на механизмот за раст на SiC кристалите во оваа студија. Како што е прикажано на слика 1, парните гасови (ST) се транспортираат до површината на семениот кристал, каде што се дифузираат и го формираат кристалот. Некои гасови кои не се вклучени во растот (ST) се десорираат од кристалната површина. Кога количината на гас на површината на семениот кристал (SG) го надминува десорбираниот гас (SD), процесот на растење продолжува. Затоа, соодветниот сооднос гас (SG)/гас (SD) за време на процесот на раст беше проучен со промена на положбата на грејниот калем RF.
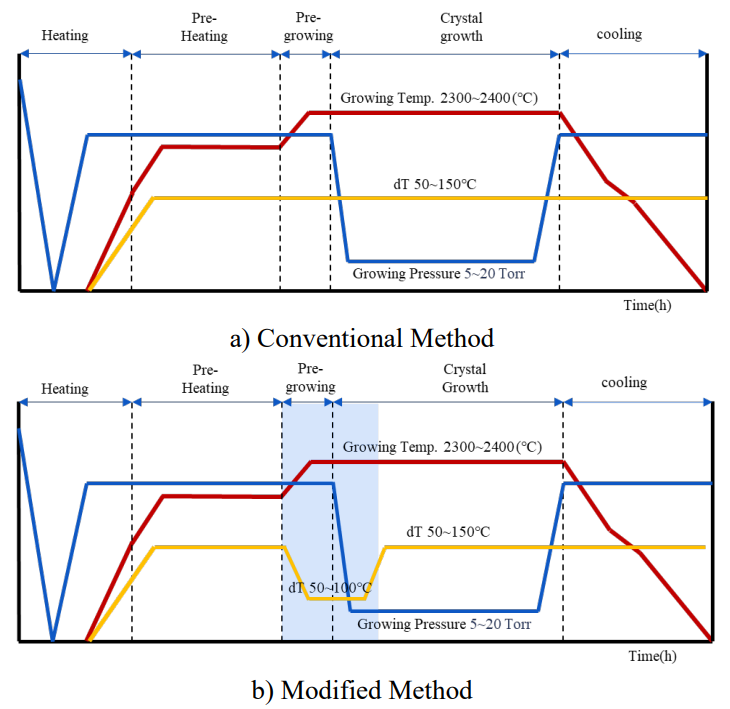
Слика 2: Шема на условите на процесот на раст на кристалите на SiC
Слика 2 ја прикажува шемата на условите на процесот на раст на кристалите на SiC во оваа студија. Типичната температура на процесот на раст се движи од 2300 до 2400°C, при што притисокот се одржува на 5 до 20 Torr. Во текот на процесот на растење, температурниот градиент се одржува на dT=50~150°C ((а) конвенционален метод). Понекогаш, нерамномерното снабдување со изворни гасови (Si2C, SiC2, Si) може да резултира со дефекти на натрупување, политипски инклузии и со тоа да го наруши квалитетот на кристалот. Затоа, во почетната фаза на раст, со промена на положбата на RF серпентина, dT беше внимателно контролирана во рамките на 50~100°C, а потоа прилагодена на dT=50~150°C за време на главниот процес на раст ((б) подобрен метод) . За да се контролира температурниот градиент (dT[°C] = Tbottom-Tupper), долната температура беше фиксирана на 2300°C, а горната температура беше прилагодена од 2270°C, 2250°C, 2200°C до 2150°C. Табела 1 ги прикажува сликите на оптичкиот микроскоп (OM) на површината на булеот SiC растени под различни услови на температурен градиент по 10 часа.
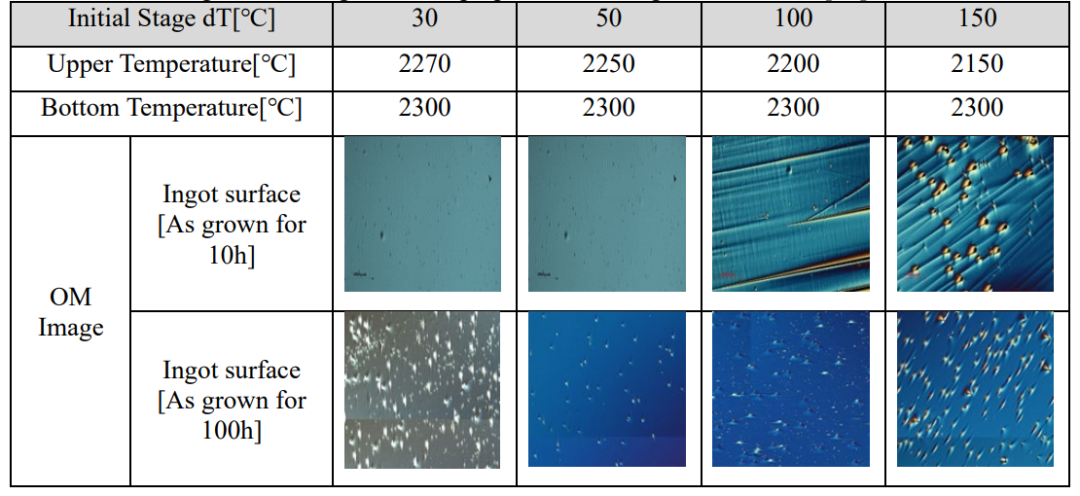
Табела 1: Слики од оптички микроскоп (OM) од површината на SiC Boule растена 10 часа и 100 часа под различни услови на температурен градиент
При почетна dT=50°C, густината на дефектот на површината на булот SiC по 10 часа раст беше значително помала од онаа под dT=30°C и dT=150°C. При dT=30°C, почетниот температурен градиент може да биде премал, што резултира со губење на семенскиот кристал и формирање на дефекти. Спротивно на тоа, при повисок градиент на почетната температура (dT=150°C), може да се појави нестабилна состојба на презаситеност, што доведува до политипски инклузии и дефекти поради високи концентрации на празни места. Меѓутоа, ако почетниот температурен градиент е оптимизиран, може да се постигне висококвалитетен раст на кристалите со минимизирање на формирањето на почетни дефекти. Бидејќи густината на дефектот на површината на булот SiC по 100 часа раст беше слична на резултатите по 10 часа, намалувањето на формирањето на дефекти за време на почетната фаза на раст е критичниот чекор во добивањето висококвалитетни SiC кристали.
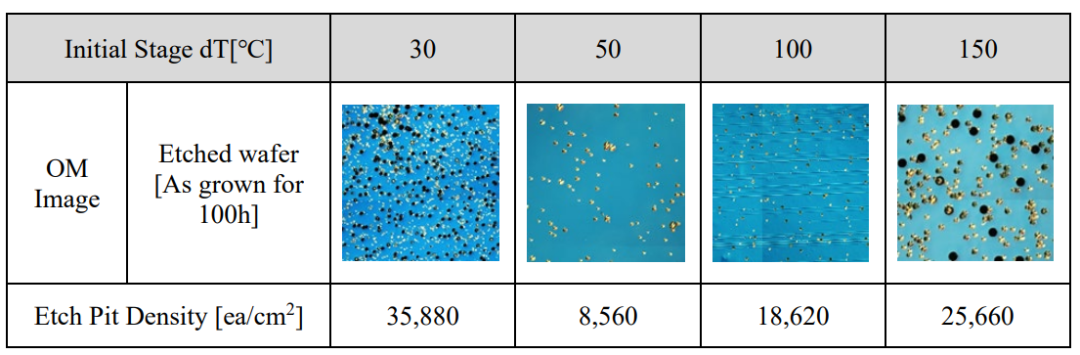
Табела 2: EPD вредности на гравирани SiC були под различни услови на градиент на температура
Наполитанкиподготвени од булови одгледувани 100 часа беа гравирани за да се проучи дефектната густина на SiC кристалите, како што е прикажано во Табела 2. Вредностите на EPD на SiC кристалите одгледувани под почетна dT=30°C и dT=150°C беа 35,880/cm² и 25,660 /cm², соодветно, додека вредноста на EPD на SiC кристалите одгледувани во оптимизирани услови (dT=50°C) значително се намали на 8.560/cm².
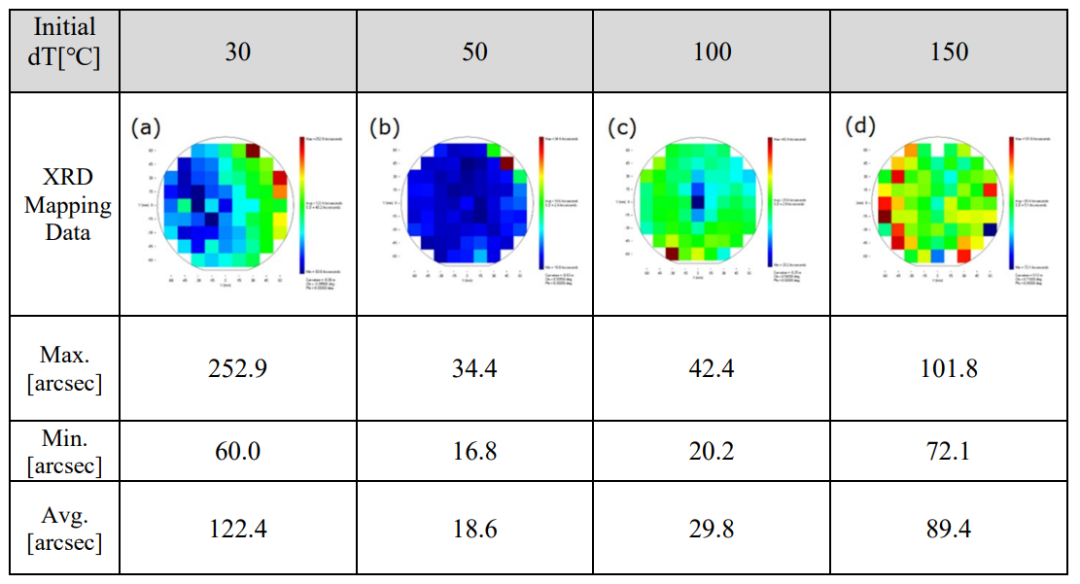
Табела 3: Вредности на FWHM и XRD мапирање слики на SiC кристали под различни услови за градиент на почетната температура
Табела 3 ги прикажува вредностите на FWHM и сликите за мапирање на XRD на SiC кристали одгледувани под различни услови на градиент на почетната температура. Просечната вредност на FWHM на SiC кристалите одгледувани во оптимизирани услови (dT=50°C) беше 18,6 лачни секунди, значително пониска од онаа на SiC кристалите одгледувани под други услови на температурен градиент.
Заклучок
Ефектот на температурниот градиент на почетната фаза на раст врз квалитетот на SiC кристалите беше проучен со контролирање на температурниот градиент (dT[°C] = Tbottom-Tupper) со промена на положбата на серпентина. Резултатите покажаа дека густината на дефектот на површината на SiC буле по 10 часа раст во почетни услови dT=50°C била значително помала од онаа при dT=30°C и dT=150°C. Просечната вредност на FWHM на SiC кристалите одгледувани во оптимизирани услови (dT=50°C) беше 18,6 лачни секунди, значително пониска од онаа на SiC кристалите одгледувани во други услови. Ова покажува дека оптимизирањето на градиентот на почетната температура ефикасно го намалува формирањето на почетни дефекти, со што се постигнува висококвалитетен раст на SiC кристалите.**




