
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe in Chip Manufacturing: Професионален извештај за вести
Еволуцијата на полупроводничките материјали
Во доменот на модерната технологија на полупроводници, немилосрдното движење кон минијатуризација ги помести границите на традиционалните материјали базирани на силикон. За да се задоволат барањата за високи перформанси и мала потрошувачка на енергија, SiGe (Силициум Германиум) се појави како композитен материјал на избор во производството на полупроводнички чипови поради неговите уникатни физички и електрични својства. Оваа статија навлегува вопроцес на епитаксијана SiGe и неговата улога во епитаксијалниот раст, затегнатите силициумски апликации и Gate-All-Around (GAA) структурите.
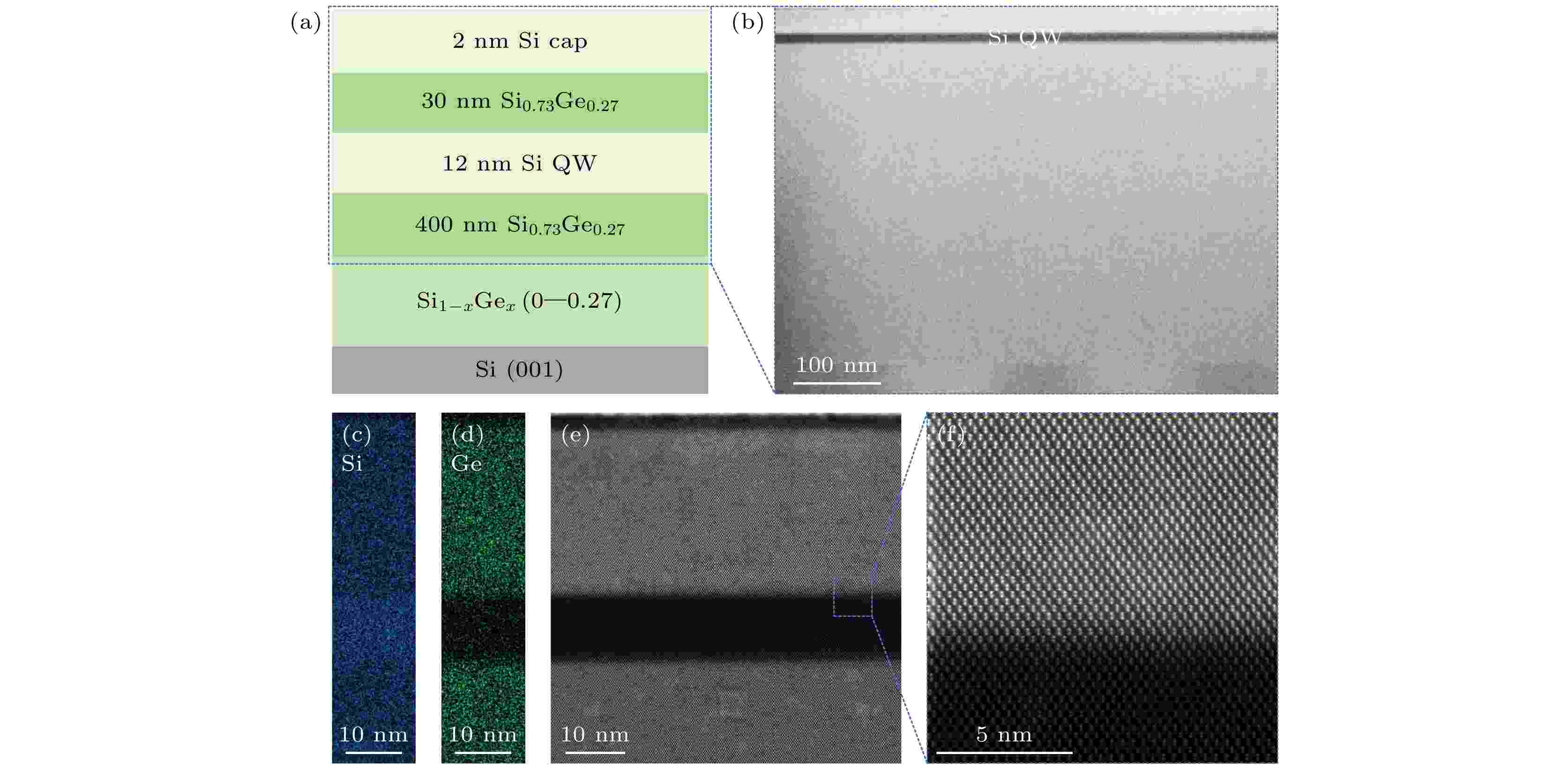
Значењето на SiGe епитаксијата
1.1 Вовед во епитаксија во производството на чипови:
Епитаксијата, често скратено како Епи, се однесува на растот на еднокристален слој на еднокристална подлога со ист распоред на решетки. Овој слој може да биде илихомоепитаксија (како Si/Si)или хетероепитаксија (како SiGe/Si или SiC/Si). Различни методи се користат за епитаксијален раст, вклучувајќи молекуларна епитаксија со зрак (MBE), ултра-висок вакуум хемиско таложење на пареа (UHV/CVD), атмосферска и епитаксија со намален притисок (ATM & RP Epi). Оваа статија се фокусира на процесите на епитаксија на силициум (Si) и силикон-германиум (SiGe) широко користени во производството на полупроводнички интегрирани кола со силициум како материјал за подлогата.
1.2 Предности на SiGe Epitaxy:
Инкорпорирање на одреден дел од германиум (Ge) во текот напроцес на епитаксијаформира SiGe еднокристален слој кој не само што ја намалува ширината на бендот, туку и ја зголемува фреквенцијата на исклучување на транзисторот (fT). Ова го прави широко применлив во уреди со висока фреквенција за безжични и оптички комуникации. Покрај тоа, во напредните процеси на интегрирано коло CMOS, несовпаѓањето на решетката (околу 4%) помеѓу Ge и Si воведува решеткаст стрес, подобрувајќи ја подвижноста на електроните или дупките и на тој начин ја зголемува заситената струја на уредот и брзината на одговор.
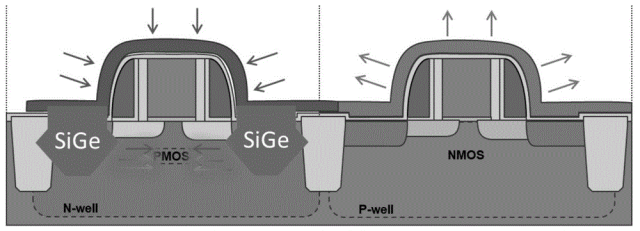
Процесот на сеопфатен тек на епитаксијата на SiGe
2.1 Предтретман:
Силиконските наполитанки се претходно обработени врз основа на посакуваните резултати од процесот, првенствено вклучувајќи го отстранувањето на природниот оксиден слој и нечистотиите на површината на обландата. За силно допингуваните наполитанки од подлогата, од клучно значење е да се разгледа дали е неопходно затварање за да се намали авто-допингот во текот на следнитераст на епитаксијата.
2.2 Гасови и услови за раст:
Силиконски гасови: Силан (SiH4), Дихлоросилан (DCS, SiH2Cl2) и Трихлоросилан (TCS, SiHCl3) се трите најчесто користени извори на силициум гас. SiH4 е погоден за процеси на целосна епитаксија на ниски температури, додека TCS, познат по својата брза стапка на раст, широко се користи за подготовка на густисиликонска епитаксијаслоеви.
Гас германиум: Герман (GeH4) е примарен извор за додавање германиум, кој се користи заедно со извори на силициум за да се формираат легури SiGe.
Селективна епитаксија: Селективен раст се постигнува со прилагодување на релативните стапки наепитаксијално таложењеи in situ офорт, со користење на силициумски гас DCS што содржи хлор. Селективноста се должи на тоа што адсорпцијата на атомите на Cl на површината на силициумот е помала од онаа на оксидите или нитридите, што го олеснува епитаксиалниот раст. SiH4, без атоми на Cl и со ниска енергија за активирање, генерално се применува само за процеси на целосна епитаксија на ниски температури. Друг најчесто користен извор на силициум, TCS, има низок притисок на пареа и е течен на собна температура, барајќи H2 клокотот да се внесе во комората за реакција. Сепак, тој е релативно евтин и често се користи за неговата брза стапка на раст (до 5 μm/min) за да се одгледуваат подебели силиконски епитаксии, широко применети во производството на силиконски епитаксии.
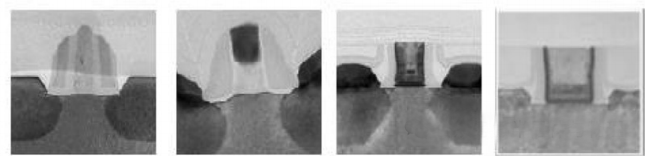
Исцеден силикон во епитаксијални слоеви
За време наепитаксијален раст, епитаксијален еднокристален Si се депонира на релаксиран SiGe слој. Поради неусогласеноста на решетката помеѓу Si и SiGe, еднокристалниот слој Si е подложен на напрегање на истегнување од основниот слој SiGe, што значително ја подобрува подвижноста на електроните во NMOS транзисторите. Оваа технологија не само што ја зголемува струјата на заситеност (Idsat), туку и ја подобрува брзината на одговор на уредот. За PMOS-уредите, SiGe слоевите се епитаксијално растени во регионите на изворот и одводот по офорт за да се воведе притисок на притисок на каналот, подобрување на подвижноста на дупките и зголемување на струјата на заситеност.
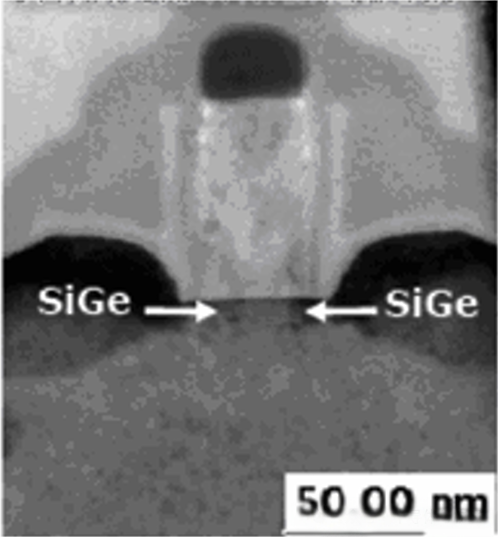
SiGe како жртвен слој во GAA структури
Во производството на наножични транзистори Gate-All-Around (GAA), слоевите SiGe дејствуваат како жртвени слоеви. Техниките на анизотропно офорт со висока селективност, како што е квази-атомското офортување (квази-ALE), овозможуваат прецизно отстранување на слоевите SiGe за да се формираат структури од наножица или нанолист.
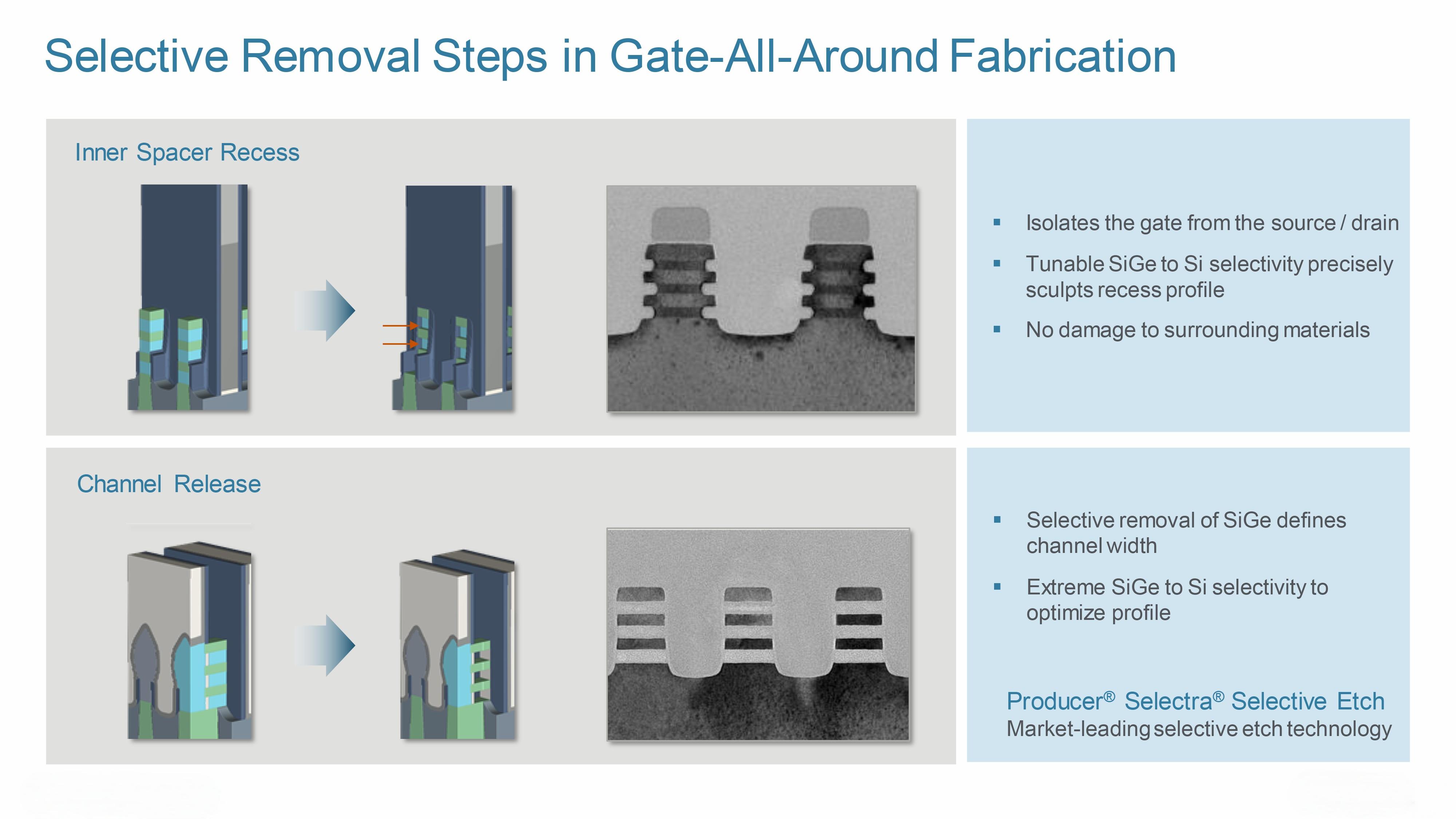
Ние во Semicorex сме специјализирани заГрафитни раствори обложени со SiC/TaCприменет во Si епитаксијален раст во производството на полупроводници, доколку имате какви било прашања или ви требаат дополнителни детали, ве молиме не двоумете се да стапите во контакт со нас.
Телефон за контакт: +86-13567891907
Е-пошта: sales@semicorex.com




