
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Разбирање на комплетниот процес на изработка на полупроводнички уреди
1. Фотолитографија
Фотолитографијата, често синоним за генерирање шаблони, е една од најкритичните движечки сили зад брзиот напредок на полупроводничката технологија, која потекнува од процесите на фотографско правење плочи во печатењето. Оваа техника овозможува презентација на која било шема на микро или нано размери со фоторезист, и кога се комбинира со други процесни технологии, ги пренесува овие обрасци на материјали, реализирајќи различни дизајни и концепти на полупроводнички материјали и уреди. Изворот на светлина што се користи во фотолитографијата директно влијае на прецизноста на шаблоните, со опции кои се движат од ултравиолетови, длабоки ултравиолетови, до рендгенски зраци и електронски зраци, што секој одговара на зголемените нивоа на верност на шаблонот по споменатиот редослед.
Стандардниот тек на процесот на фотолитографија вклучува подготовка на површината, адхезија, меко печење, експозиција, печење после експозиција, развој, тврдо печење и проверка.
Површинскиот третман е императив бидејќи супстратите обично ги апсорбираат молекулите на H2O од воздухот, што е штетно за фотолитографијата. Затоа, супстратите првично се подложени на обработка на дехидрација преку печење.
За хидрофилни супстрати, нивната адхезија на хидрофобниот фоторезист е недоволна, што потенцијално предизвикува одвојување на фоторезистот или неусогласеност на шаблонот, а со тоа и потреба од промотор на адхезија. Во моментов, хексаметил дисилазан (HMDS) и три-метил-силил-диетил-амин (TMSDEA) се широко користени подобрувачи на адхезијата.
По површинската обработка, започнува примената на фоторезист. Дебелината на применетиот фоторезист не е само поврзана со неговата вискозност, туку е под влијание и на брзината на обложување на центрифугирање, генерално обратно пропорционална на квадратниот корен на брзината на центрифугирање. По премачкувањето, се врши меко печење за да се испари растворувачот од фоторезистот, со што се подобрува адхезијата во процесот познат како предпечење.
Откако ќе завршат овие чекори, се случува изложување. Фоторезистите се класифицирани како позитивни или негативни, со спротивни својства по експозицијата.
Земете го како пример позитивниот фоторезист, каде што неизложениот фоторезист е нерастворлив во развивачот, но станува растворлив по експозицијата. За време на експозицијата, изворот на светлина, минувајќи низ маска со шаблони, ја осветлува обложената подлога, обликувајќи го фоторезистот. Вообичаено, подлогата мора да биде усогласена со маската пред изложувањето за прецизно да се контролира позицијата на изложување. Мора строго да се управува со времетраењето на експозицијата за да се спречи искривување на шемата. По изложувањето, може да биде потребно дополнително печење за да се ублажат ефектите од стоечките бранови, иако овој чекор е изборен и може да се заобиколи во корист на директен развој. Развојот го раствора изложениот фоторезист, прецизно пренесувајќи го шаблонот на маската на слојот на фоторезист. Времето на развој е исто така критично - прекраткото води до нецелосен развој, предолгото предизвикува изобличување на шемата.
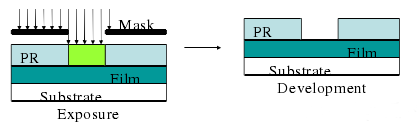
Последователно, тврдото печење го зајакнува прицврстувањето на фоторезистната фолија на подлогата и ја подобрува неговата отпорност на гравирање. Температурата на тврдото печење е генерално малку повисока од онаа на претходното печење.
Конечно, микроскопската инспекција потврдува дали шемата се усогласува со очекувањата. Откако шаблонот се префрли на материјалот со други процеси, фоторезистот ја исполни својата цел и мора да се отстрани. Методите на соголување вклучуваат влажно (со користење на силни органски растворувачи како ацетон) и суво (со користење на кислородна плазма за да се издлаби филмот).
2. Допинг техники
Допингот е незаменлив во технологијата на полупроводници, менувајќи ги електричните својства на полупроводничките материјали по потреба. Вообичаените методи за допинг вклучуваат термичка дифузија и имплантација на јони.
(1) Имплантација на јони
Имплантацијата на јони ја натопува полупроводничката подлога со тоа што ја бомбардира со високоенергетски јони. Во споредба со термичката дифузија, има многу предности. Јоните, избрани со анализатор на маса, обезбедуваат висока допинг чистота. Во текот на целата имплантација, подлогата останува на собна температура или малку погоре. Може да се користат многу филмови за маскирање, како што се силициум диоксид (SiO2), силициум нитрид (Si3N4) и фоторезист, обезбедувајќи висока флексибилност со техниките за самопорамнети маски. Дозите на имплантот се прецизно контролирани, а дистрибуцијата на јоните на имплантирана нечистотија е рамномерна во истата рамнина, што резултира со голема повторливост.
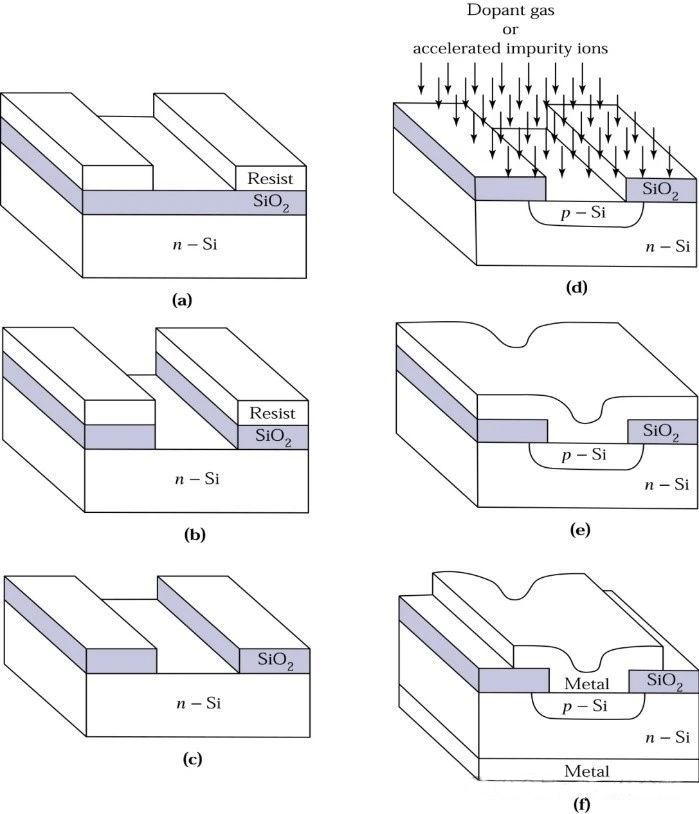
Длабочината на имплантација се одредува според енергијата на јоните. Со регулирање на енергијата и дозата, може да се манипулира со дистрибуцијата на јони на нечистотија во подлогата по имплантацијата. Повеќекратните имплантации со различни шеми може да се вршат континуирано за да се постигнат различни профили на нечистотии. Имено, во еднокристалните подлоги, ако насоката на имплантација е паралелна со кристалографската насока, се јавуваат канализирачки ефекти - некои јони ќе патуваат по каналите, што ќе ја прави контролата на длабочината предизвик.
За да се спречи канализирање, имплантацијата обично се изведува под агол од околу 7° во однос на главната оска на еднокристалната подлога или со покривање на подлогата со аморфен слој.
Сепак, имплантација на јони може значително да ја оштети кристалната структура на подлогата. Високо-енергетските јони, при судир, ја пренесуваат енергијата на јадрата и електроните на подлогата, предизвикувајќи ги да ја напуштат решетката и да формираат парови на дефекти на интерстицијално празно место. Во тешки случаи, кристалната структура во некои региони може да биде уништена, формирајќи аморфни зони.
Оштетувањето на решетката во голема мера влијае на електричните својства на полупроводничкиот материјал, како што е намалувањето на подвижноста на носачот или животниот век на носачите кои не се во рамнотежа. Што е најважно, поголемиот дел од имплантирани нечистотии зафаќаат неправилни интерстицијални места, не успевајќи да формираат ефективен допинг. Затоа, поправката на оштетувањето на решетката по имплантација и електричното активирање на нечистотиите се од суштинско значење.
(2)Брза термичка обработка (RTP)
Термичкото жарење е најефективниот метод за изменување на оштетувањето на решетката предизвикано од имплантација на јони и електрично активирачки нечистотии. При високи температури, паровите со дефекти на интерстицијално празно место во кристалната решетка на подлогата ќе се рекомбинираат и ќе исчезнат; аморфните региони исто така ќе се рекристализираат од границата со еднокристалните области преку цврстофазна епитаксија. За да се спречи оксидација на материјалот на подлогата на високи температури, термичкото жарење мора да се изврши во вакуум или атмосфера на инертен гас. Традиционалното жарење трае долго време и може да предизвика значителна прераспределба на нечистотијата поради дифузија.
Доаѓањето наRTP технологијаго решава ова прашање, во голема мера постигнувајќи поправка на оштетувањето на решетката и активирање на нечистотијата во скратено времетраење на жарењето.
Во зависност од изворот на топлина,RTPсе категоризира во неколку типови: скенирање со електронски сноп, импулсни електронски и јонски зраци, импулсни ласери, ласери со континуирани бранови и широкопојасни некохерентни извори на светлина (халогени светилки, графитни грејачи, лачни ламби), при што вторите се најшироко користени. Овие извори можат да ја загреат подлогата до потребната температура за миг, завршувајќи го жарењето за кратко време и ефикасно намалувајќи ја дифузијата на нечистотијата.
3. Техники на таложење на филмот
(1) Хемиско таложење на пареа засилено со плазма (PECVD)
PECVD е една од формите на хемиско таложење на пареа (CVD) техника за таложење филм, а другите две се CVD со атмосферски притисок (APCVD) и низок притисок CVD (LPCVD).
Во моментов, PECVD е најраспространета меѓу трите типа. Тој користи радиофреквентна (RF) плазма за да започне и одржува хемиски реакции на релативно ниски температури, со што го олеснува таложењето на филмот на ниска температура со високи стапки на таложење. Шемата за неговата опрема е како што е илустрирано.
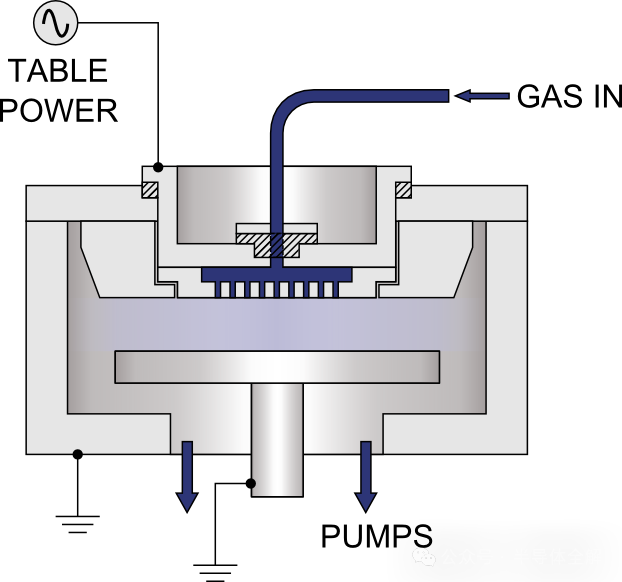
Филмовите произведени со овој метод покажуваат исклучителни адхезивни и електрични својства, минимална микропорност, висока униформност и робусни способности за полнење во мали размери. Факторите кои влијаат на квалитетот на таложењето на PECVD вклучуваат температура на подлогата, брзина на проток на гас, притисок, моќност на RF и фреквенција.
(2) Прскање
Распрскувањето е метод на физичко таложење на пареа (PVD). Наполнетите јони (најчесто јони на Аргон, Ar+) се забрзуваат во електрично поле, добивајќи кинетичка енергија. Тие се насочени кон целниот материјал, судирајќи се со целните молекули и предизвикувајќи нивно отстранување и распрскување. Овие молекули, исто така, поседуваат значителна кинетичка енергија и се движат кон подлогата, таложејќи се на неа.

Вообичаено користените извори на енергија за распрскување вклучуваат директна струја (DC) и радиофреквенција (RF), каде што еднонасочното прскање е директно применливо за спроводливи материјали како што се металите, додека за изолационите материјали е потребно RF прскање за таложење на филмот.
Конвенционалното прскање страда од ниски стапки на таложење и високи работни притисоци, што резултира со понизок квалитет на филмот. Магнетронското прскање поидеално ги решава овие прашања. Тој користи надворешно магнетно поле за да ја промени линеарната траекторија на јоните до спирален пат околу насоката на магнетното поле, продолжувајќи го нивниот пат и подобрувајќи ја ефикасноста на судирот со целните молекули, а со тоа ја зголемува ефикасноста на распрскувањето. Ова резултира со зголемени стапки на таложење, намален работен притисок и значително подобрен квалитет на филмот.
4. Офорт Техники
Офорт е класифициран во сув и влажен режим, именуван поради нивната употреба (или недостаток) на специфични решенија соодветно.
Вообичаено, офорт бара подготовка на слој за маска (кој може директно да биде фотоотпорен) за да ги заштити областите што не се наменети за офорт.
(1) Сува офорт
Вообичаените типови на суво офорт вклучуваатИндуктивно споена плазма (ICP) офорт, офорт со јонски сноп (IBE) и реактивен јонски офорт (RIE).
При офорт со ICP, плазмата произведена со празнење со сјај содржи бројни високо хемиски активни слободни радикали (слободни атоми, молекули или атомски групи), кои хемиски реагираат со целниот материјал за да формираат испарливи производи, со што се постигнува офорт.
IBE користи високоенергетски јони (јонизирани од инертни гасови) за директно бомбардирање на површината на целниот материјал за офорт, што претставува физички процес.
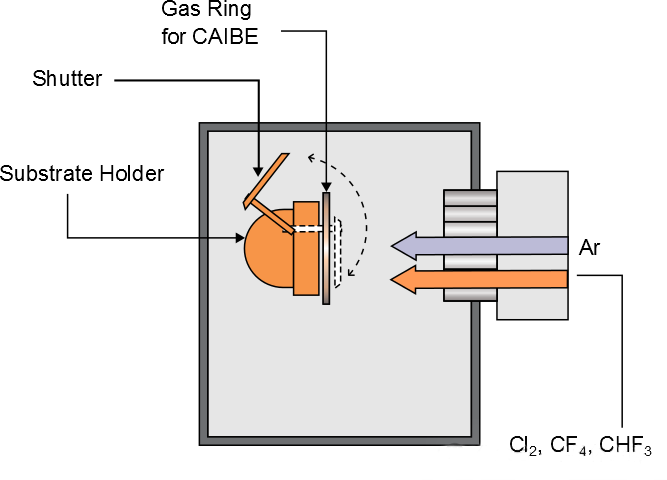
RIE се смета за комбинација од претходните два, заменувајќи го инертниот гас што се користи во IBE со гасот што се користи во ICP офорт, со што се формира RIE.
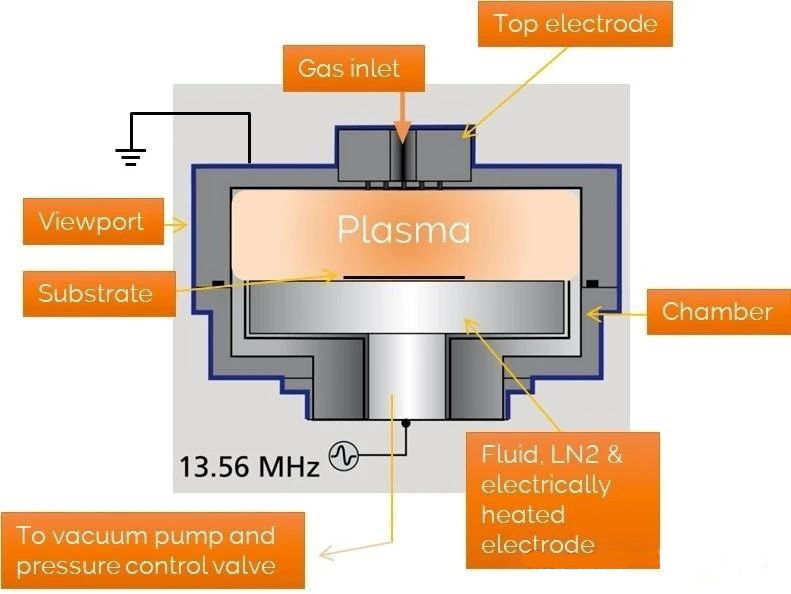
За суво офорт, вертикалната стапка на офорт далеку ја надминува страничната стапка, т.е. има висок сооднос, овозможувајќи прецизна репликација на шаблонот на маската. Сепак, сувото офорт го опишува и слојот на маската, покажувајќи послаба селективност (односот на стапките на офорт на целниот материјал до слојот на маската), особено со IBE, кој може неселективно да се гравира низ површината на материјалот.
(2) Влажно офортување
Влажното офорт го означува методот на офорт кој се постигнува со потопување на целниот материјал во раствор (етчант) кој хемиски реагира со него.
Овој метод на офорт е едноставен, исплатлив и покажува добра селективност, но има низок сооднос. Материјалот под рабовите на маската може да се кородира, што го прави помалку прецизен од сувото офортување. За да се ублажат негативните влијанија од нискиот сооднос, мора да се изберат соодветни стапки на офорт. Фактори кои влијаат на брзината на офорт вклучуваат концентрација на офорт, време на офорт и температура на офорт.**




